CEPLAX®BLADE
セプラックス®ブレード
各種被削材に合わせ開発した当社独自のポリイミドレジンボンドブレードです。
セプラックスブレードの用途・特徴・開発について

CHARACTERISTICS OF CEPLAX®BLADE
セプラックス®ブレードの特徴
超耐熱樹脂ポリイミドをボンドに使用することより熱劣化が少ない。ポリイミド樹脂は剛性が非常に高いため耐磨耗性や形状維持に優れています。
右図の大きな黒い点部分がダイヤになり、細い粒子部分がボンドになります。

QFN CUT OF CEPLAX®BLADE
セプラックス®ブレードの QFNカット
切断でのポイント:リードが外周部の端子に無いことが特徴であり、切断面の端子である銅のバリ(端子間距離)制御が重要となります。
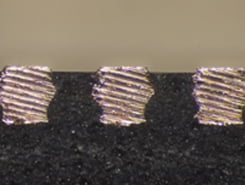
セプラックス®ブレード
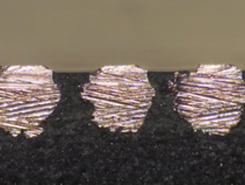
NG:バリ(引きづりアリ)
ブレード表示方法
| 例:(EX.):SD600-25-CX6B 56D/0.1T/40H | ||||||
| 粒度 | 粒度 | 集中度 | ボンド名 | 外形 | 厚さ | 内径 |
| SD | 600 | 25 | CX6B | 56D | 0.1T | 40H |
標準粒経
| 粒径 | 粒度 |
| 2/6 | #3000 |
| 3/8 | #2000 |
| 5/12 | #1500 |
| 8/16 | #1200 |
| 10/20 | #1000 |
| 12/25 | #800 |
| 20/30 | #600 |
| 30/40 | #500 |
| 40/60 | #400 |
| #325 | |
| #270 | |
| #230 |
ブレードボンド種類
| 砥粒種 | ボンドタイプ | 集中度 |
| SD SDC CBN |
CX48(↑HARD) | 15-125 |
| CX88 | ||
| CX4N | ||
| CX8N(↓SOFT) |
※メタルブレードのボンド種類も上記以外に多数ご用意しております。
またお客様のご要望に合わせてのボンドの設計も致しますので、詳しくは当社お問合せフォームからお問い合わせ下さい。
ブレード製造可能サイズ・公差
| 項目 (Object) | 製造可能範囲(Limitation) | 公差 (Tolerance ) | |||||||||
| 外径(OD) | Φ46mm~80mm以下 | 土0.02,-0 | |||||||||
| 内径 (ID) | 40H | H6 | |||||||||
| 厚み(Thickness) | 0.1~ 0.5mm | 土0.005 |
※厚さの公差は砥粒経により、変更になる場合がございます。
PRODUCT NOTES
製品に関する注意事項
ウェブサイトに掲載されているデータ・数値は保証値ではありませんのでご注意下さい。ご不明点等はお問合せフォームからお気軽にお問い合わせ下さい。



